材料分析與檢驗在製造和生產過程中扮演著極重要的角色,對於確保產品品質、提高生產效率和滿足客戶需求至關重要。
上濰團隊與合作夥伴可協助客戶進行以下材料分析或監控。不論半導體業界或是其他產業在品質監控或製程能力提升上,都可以透過分析服務來達到所需要的目的。
此外,本公司持續規畫建置各種量測資源,亦可提供各式量測資源代詢代送服務。
現代科學研究與工業應用中,精確的元素分析是一項關鍵技術。感應耦合電將質譜儀(ICP-MS)作為一種高靈敏度、高分辨率且可同時分析多種元素的先進技術,正越來越受到重視。
ICP-MS的分析過程是將待測樣品以水溶液形式經霧化方式導入高溫氬氣電漿中產生離子。這些離子隨後進入真空系統,經由四極柱和偵測器,通過質荷比和離子數對元素進行確認並定量其濃度。

上濰科技具有相當經驗, 且ICP-MS機台具備高度靈敏度和精確度,能夠針對各類物質進行全面性的分析。我們的量測服務涵蓋水質、晶片、O-ring密封圈以及各種粉體材料等等,無論是微量元素的檢測還是複雜的樣品分析,我們都能提供專業且可靠的支援,助您深入了解材料的成分和品質。
目前,上濰科技擁有的Agilent7900能夠檢測的元素範圍廣泛,從6到260 amu (Li到U),總計68種元素。如果有特殊元素需求,也歡迎客戶與我們聯繫;另外ICP-MS的分析範圍從ppt到ppm級別,確保了極高的檢測靈敏度。
在ICP-MS的分析過程中,我們使用
我們的實驗室環境為CLASS100等級的無塵室;無塵室提供優於業界的空氣微粒環境,這樣的環境有以下優點:
我們為通過ISO/IEC 17025:2017國際認證的實驗室,可確保每一件測試均有從始至終的標準流程;ICP-MS量測作業的標準程序如下:
完成分析後,我們將產出詳細且完整的數據報告,供客戶參考;我們也承諾提供優於業界的回饋時間,讓客戶的專案進展更順利、更高效。
我們的專業團隊還可協助進行深入的數據統計分析,確保結果精確可靠,助客戶快速做出最佳決策。
另外,上濰近期增設了高效能的微波消化器,此措施將顯著提升ICP-MS的前處理能力,特別是在樣品消化方面,使其能夠更高效地處理各類複雜基質的樣品;我們也將提供更多領域的委測服務。[詳請參照微波消化器]
 為了保證分析結果的準確性,煩請客戶在提供樣品時留意以下幾點:
為了保證分析結果的準確性,煩請客戶在提供樣品時留意以下幾點:

若您有更進一步想要了解,歡迎洽詢喔!
ICP-MS技術在元素分析中展示了其無與倫比的優勢,不論是在科研還是工業應用中,都扮演著不可或缺的角色。上濰科技致力於提供最先進的ICP-MS分析服務,期待與您合作,共同探索微量元素的奧秘。
聯絡窗口 | 徐先生 Jack Hsu
email: jackhsu@msp-sw.com tel: 03-4884766
 @102dgxnw
@102dgxnw
一款靈活的單四極ICP質譜儀,提供了業界最佳的基質容限、最有效的氦氣碰撞模式、最低的檢測限和最寬的動態範圍。
ICP-MS代表Inductively Coupled Plasma Mass Spectrometry(感應耦合等離子體質譜儀),是一種高靈敏度、高分辨率的分析技術,主要用於測定元素的存在和濃度。
ICP-MS的原理基於樣品被注入到感應耦合等離子體中,形成高溫等離子體。該等離子體中的能量足以將樣品中的原子離子化。離子化的原子經過質譜儀分離和檢測,根據其質量/電荷比,可以確定元素的存在和濃度。
Reference: www.agilent.com
高靈敏度
ICP-MS具有極高的靈敏度,可以檢測到極低濃度的元素,四極杆ICP-MS中最寬的動態範圍,提供高達11個數量級的動態範圍,從ppt級到百分級濃度。
高分辨率
由於使用質譜儀,ICP-MS具有高分辨率,使其能夠區分非常接近質量的不同元素。
多元素分析
ICP-MS可同時測定多種元素,這使其在不同領域的分析應用中廣泛使用,如環境監測、生物醫學研究、食品檢測等。
快速反饋
ICP-MS 7900具有超快速資料獲取功能,每秒可完成10000次獨立測量。
可提供微量元素、雜質定量分析及深度剖析;以半導體材料為主,包括金屬和介質材料。 透過檢測可提供元素構成和化學結構的信息。可擴展應用於分析絕緣材料和生物醫學材料。
二次離子質譜儀(Secondary Ion Mass Spectrometry,SIMS)是一種高靈敏度的表面分析技術,常被應用於半導體、材料科學、生命科學和地質學等領域。SIMS能夠提供對表面的元素組成和化學結構的非常細緻的資訊。
高空間分辨率
SIMS具有很高的空間分辨率,可以達到亞微米或更小的尺度,因此可以對微小的區域進行高精度的分析。
高靈敏度
SIMS能夠檢測非常低濃度的元素,通常在百萬分之一至十億分之一的濃度範圍。
表面成份分析
SIMS主要應用於表面分析,因此對材料表面的成分和結構提供了詳細資訊。
可分析材料表面型貌及物理特性、樣品硬度等材料機械性質量測。
AFM代表原子力顯微鏡(Atomic Force Microscope),是一種高解析度的顯微鏡,具有許多用途。 它是一種強大的工具,對於各種領域的奈米級別研究和應用都具有重要的作用,包括材料科學、生物學、奈米技術等等
專利技術
Dimension Edge 採用布魯克專利的PeakForce Tapping ®技術,提供同類產品中,高水平的原子力顯微鏡性能、功能。
應用廣泛
可按照不同的研究方向制定相應的實驗方案,並擁有先進的納米級測量能力。
精準量測
具有低漂移、低噪音的特點,提高數據獲取速度和可靠性。其整合的可視化回饋和預配置設置,使其如專家現場操作般,測量結果高度一致。
此設備集結了光學顯微鏡、掃描電子顯微鏡和表面粗糙度儀的功能
雷射掃描式共軛焦顯微鏡(Laser Scanning Confocal Microscope,LSCM)是一種先進的光學成像技術,提供了高解析度、高對比度和實時觀察的能力,使其成為各種領域材料科學或生物科學等領域中不可或缺的工具。
掃描系統
LSCM包含一個掃描系統,它使用鏡片或棱鏡來定向激光束,使其在樣本表面上移動。通過定點光源的快速掃描,LSCM能夠在三維空間中構建高解析度的影像。
共焦技術
通過使用共焦技術,系統可以確保只有來自焦點平面的光通過檢測器,從而消除來自樣本其他部分的散射光。這提高了影像的對比度和解析度。
三維成像
由於掃描系統的特點,LSCM能夠在不同深度的焦點平面上獲取影像。這使得研究者能夠構建出高度詳細的三維樣本結構。
材料分析的高端設備,應用於先進材料科學、科學與工業薄膜技術、半導體製程開發等領域,可用於研究和分析晶體結構、結晶相、晶格參數、晶體尺寸等的量測
材料分析的高端設備,應用於先進材料科學、科學與工業薄膜技術、半導體製程開發等領域,可用於研究和分析晶體結構、結晶相、晶格參數、晶體尺寸等的量測。
X’Pert3 MRD系列具有先進的功能和性能,使其成為材料科學領域重要的分析工具。 以下是一些其主要特點:
半導體和單晶晶圓
無論是用於生長研究還是設備設計,使用高分辨率XRD對結構層品質、厚度、應力和合金組分進行量測的過程已成為電子和光電子多層半導體設備的研發核心所在。
借助多種可供選擇的X射線反射鏡、單色器和探測器,X’Pert3 MRD和MRD XL提供了高分辨率配置以適應不同的材料系統-從晶格匹配半導體,到遲豫緩衝層,再到非標準基片上的新型外來層。
多晶固體和薄膜
無論是用於生長研究還是設備設計,使用高分辨率XRD對結構層品質、厚度、應力和合金組分進行量測的過程已成為電子和光電子多層半導體設備的研發核心所在。
多晶層和塗層是許多薄膜和多層設備的重要組成部分。沈積過程中多晶層型態的演變是功能材料研發的主要研究領域。
X’Pert3 MRD和X’Pert3 MRD XL 可全面配備狹縫系統、平行光X射線反射鏡、多毛細管透鏡、交叉狹縫和單毛細管等一系列入射光路部件以供反射率、應力、織構和物相鑑定測試來做選擇。
超薄膜、奈米材料和非晶層
功能設備可能包含無序、非晶或奈米複合材料薄膜。 X‘Pert3 MRD和MRD XL系統的靈活性允許結合使用多種分析方法。
提供了一系列高分辨率光學器件,狹縫和平行板准直器來為掠入射、面內衍射和反射率測試實現最佳的性能。
非常溫條件下的量測
研究材料在各種條件下的變化是材料研究和過程開發的一個重要組成部分。
X’Pert3 MRD和MRD XL經過了專門的設計,可輕鬆整合Anton Paar提供的DHS1100非常溫樣品台,從而能夠在一系列溫度範圍和惰性氣體環境下自動進行量測。
損傷層移除量對製程來說,是必須謹慎評估的項目,移除量過多會造成產量降低以及成本增加;但移除量過少,則會有極高的加工破片或缺陷形成的風險;為了解決這樣的問題,我們可以透過有效的分析方法,檢測出損傷層深度,讓後端製程可調整準確的移除厚度。
損傷層移除量對製程來說,是必須謹慎評估的項目,移除量過多會造成產量降低以及成本增加;但移除量過少,則會有極高的加工破片或缺陷形成的風險;為了解決這樣的問題,我們可以透過有效的分析方法,檢測出損傷層深度,讓後端製程可調整準確的移除厚度。
晶片製造過程中,從晶棒外徑研磨、晶棒切片一直到晶片研磨,晶棒及晶片會因受到外力作用而在晶棒及晶片表面會形成損傷,即所謂的損傷層(Damaged Layer);若未適當地移除損傷層,晶片在後續製程中會有很大機率發生破片問題或形成缺陷,進而影響良率。
因此,損傷層移除量對製程來說,是必須謹慎評估的項目,移除量過多會造成產量降低以及成本增加;但移除量過少,則會有極高的加工破片或缺陷形成的風險,影響整體良率。
為了解決這樣的問題,我們可以透過有效的分析方法,檢測出損傷層深度,讓後端製程可調整準確的移除厚度。
損傷層常發生在:
晶棒外徑研磨機:損傷層出現在晶棒研磨後的外徑;
晶棒切片機:損傷層出現在晶片兩面;
晶片研磨機:損傷層出現在晶片兩面。
晶棒外徑研磨機

晶棒切片機
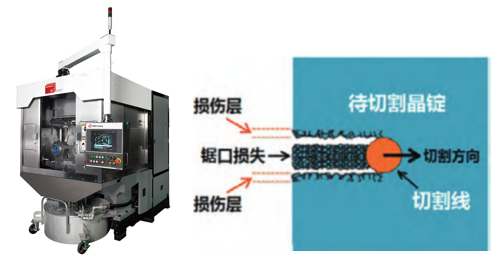
晶棒切片機
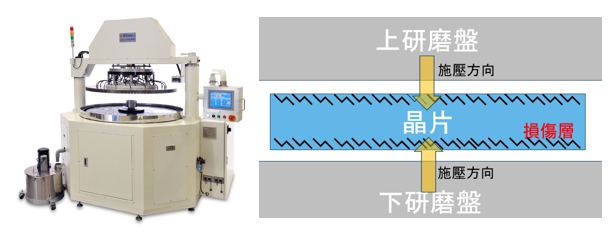

最終經過蝕刻後的樣品在顯微鏡下,損傷層可明確被觀察、定義及量測,將量測數值經過運算可得到損傷層真正的深度,供客戶參照。
| 樣品 | 8吋<100> | 製程站點 | 研磨 |
| 照片 | 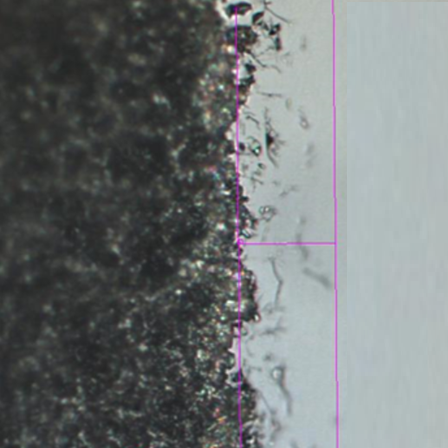 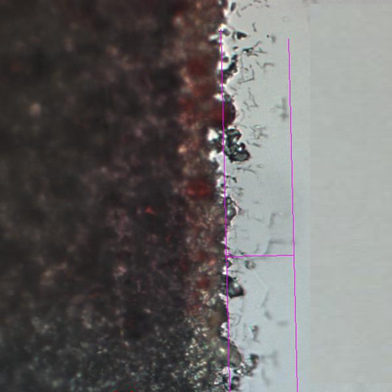 |
||
| 樣品 | 8吋<100> | 製程站點 | 切片 |
| 照片 | 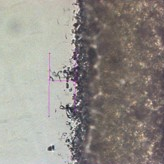  |
||
| 樣品 | 6吋<100>摻氮 | 製程站點 | 研磨 |
| 照片 |   |
||
| 樣品 | 6吋<100>晶棒 | 製程站點 | 外徑滾磨 |
| 照片 | 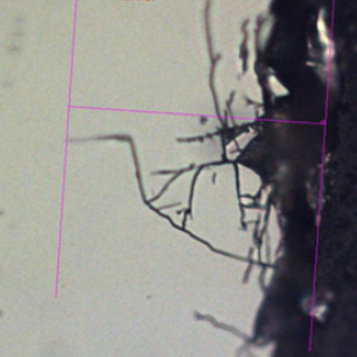 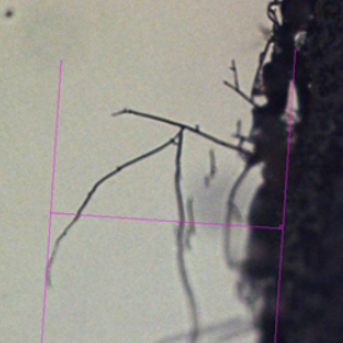 |
||
先進的微波消化系統,適用於樣品前處理,如消化。可廣泛應用於環境分析、食品檢測、製藥、材料科學及其他領域。
微波消化是一種高效的樣品前處理技術,主要透過高溫及加壓方式來加速樣品的溶解和消化,縮短樣品前處理時間及降低汙染風險,以便後續的元素分析(如ICP-MS或ICP-OES等)。
很高興地為大家介紹, 上濰近期增設了高效能的微波消化器,將顯著提升我們對各種樣品的前處理能力,妥善處理來自不同客戶的挑戰,使其能夠更高效地處理各類複雜的樣品;我們也將提供更多領域的委測服務, 包含但不限以下:
我們的優勢有:
✅ 高效率:我們的消化系統具高通量處理能力,能同時處理多個樣品,可大幅縮短前處理時間50%以上,讓您的檢測結果更快出爐!
✅ 高功能:最高 250°C & 40 bar 的高溫高壓處理,即使是最難處理的金屬、陶瓷或有機樣品,也能確保完全消解,提供更準確的分析結果。
✅ 低污染:密閉的處理系統可以減少樣品損失與污染的風險。
✅ 智慧系統:即時壓力監測、容器自動鎖定, 加上觸控介面及預設消解方法等功能,可確保每次測試條件一致,大幅減少變數,確保分析過程穩定無誤,讓您的檢測結果更可靠。
若您有任何委測需求,請直接聯繫我們,我們將盡力為您服務!











 ▲倒易空間探索
▲倒易空間探索 ▲搖擺曲線分析
▲搖擺曲線分析 ▲結構分析
▲結構分析 ▲反射率
▲反射率 ▲掠入射物相鑑定
▲掠入射物相鑑定
 ▲面內衍射
▲面內衍射
 ▲隨溫度和時間變化的峰高
▲隨溫度和時間變化的峰高

 諮詢信箱 x
諮詢信箱 x